SiC(炭化ケイ素)-MOSFET絶縁破壊故障の低温スクリーニング手法の研究


キーワード
研究シーズの紹介
SiC-MOSFETは、次世代省エネデバイスとして大きな期待を集め、各社が量産を開始しました。しかし、ゲート絶縁膜故障の落ちこぼれ(Bモード故障)に懸念が残り、本命の電気自動車(EV)への応用は遅れています。
我々はこのたび、絶縁破壊試験を低温(-60℃)で行うことで、Bモード故障がより顕在化される実験結果を得ました。(下図、欧州SiC国際会議2021にてポスター発表、論文受理)本知見の再現性を最新の量産品を用いて確認するとともに、より効率的なスクリーニング手法の開発、及び、Bモード故障メカニズムの解明に向けて研究を継続して行きます。
【研究者情報】
理工学部 電気工学科 村上 英一
Point
ゲート絶縁膜Bモード故障スクリーニング
- -60℃という低温でゲートストレス電圧を印可することで欠陥部に選択的にホール捕獲を起こし、早く絶縁破壊させ効率的に除去する手法。
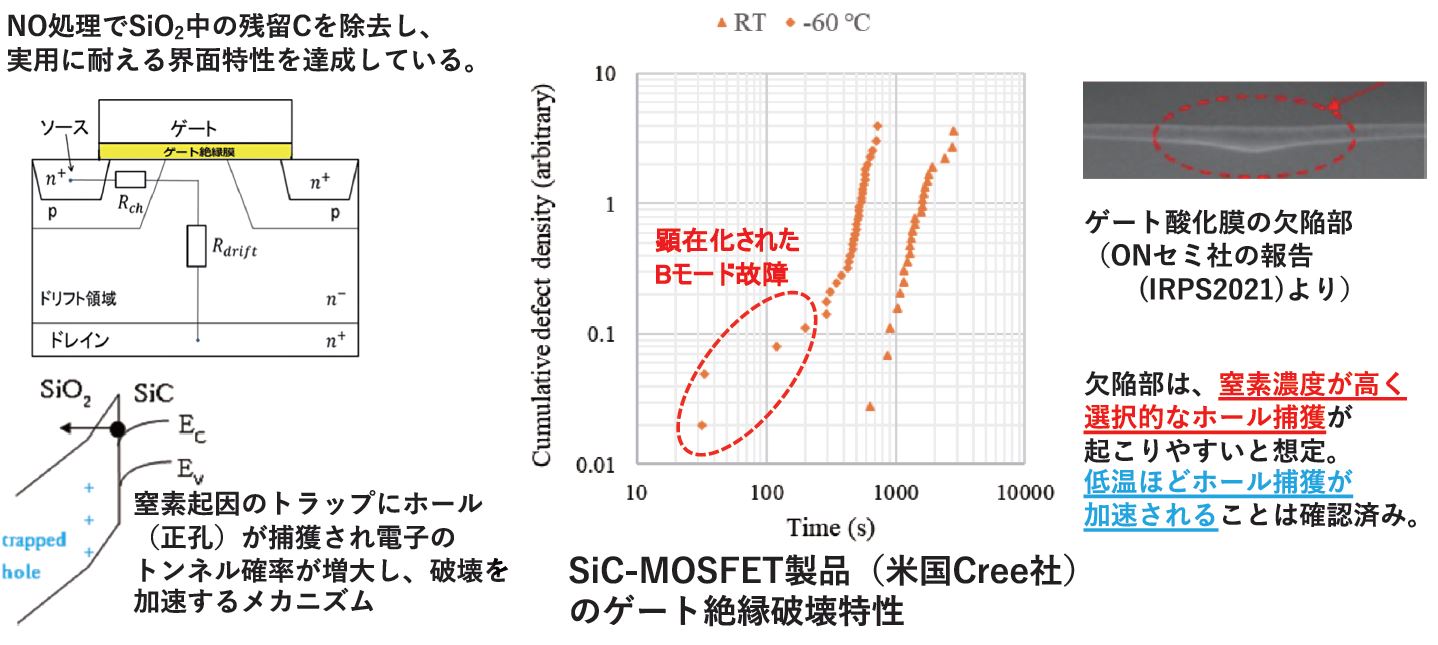
期待される活用シーン

その他の研究テーマ
- SiC-MOSFETとRaspberry Piを用いた太陽電池のMPPT制御に関する教育研究





